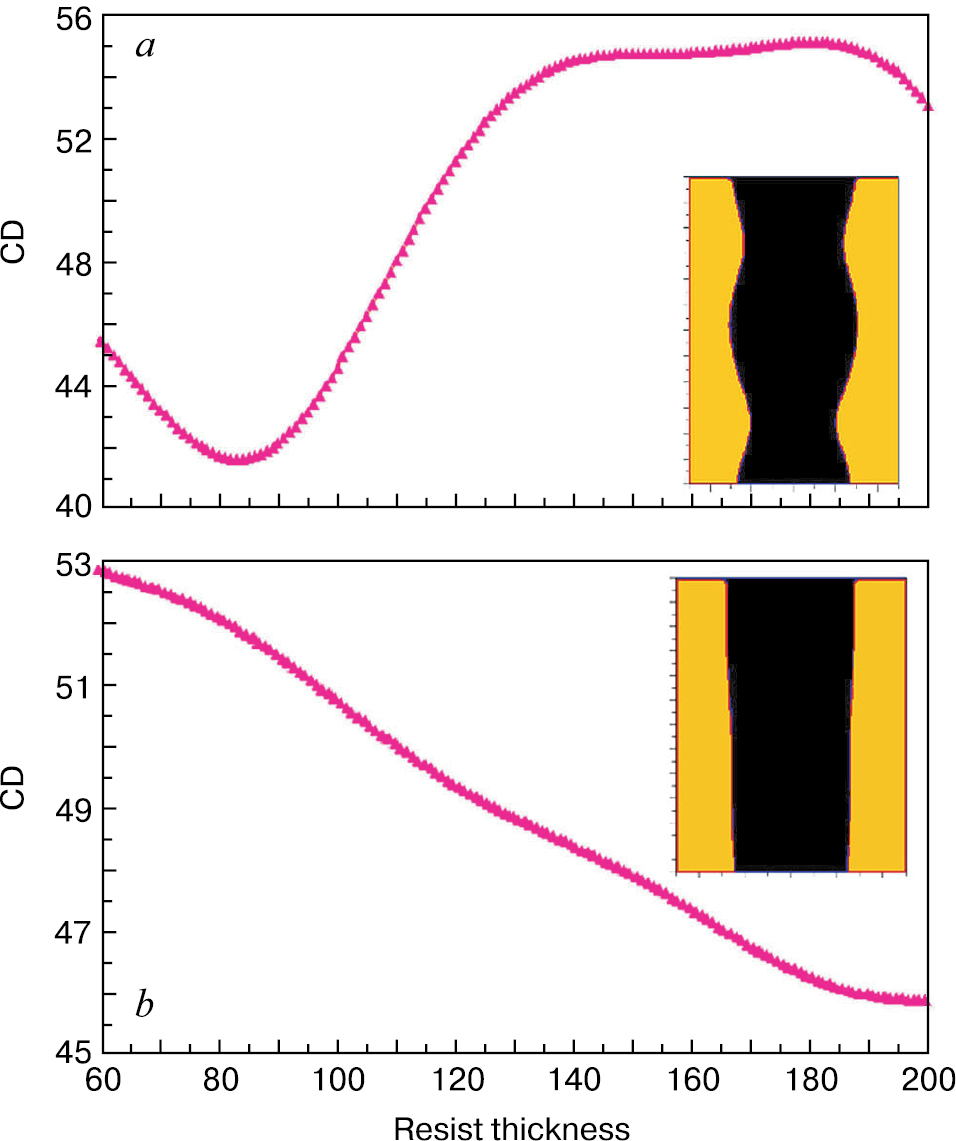
|
||
|
CD swing curves and resist profiles (120 nm height, 21.298 mJ/cm2 dose): (a) non-optimized lithographic stack; (b) optimized lithographic stack. |
|
||||||||
| Part of: Balan NN, Ivanov VV, Kuzovkov AV, Sokolova EV, Shamin ES (2020) Basic approaches to simulation of resist mask formation in computational lithography. Modern Electronic Materials 6(1): 37-45. https://doi.org/10.3897/j.moem.6.1.55056 |