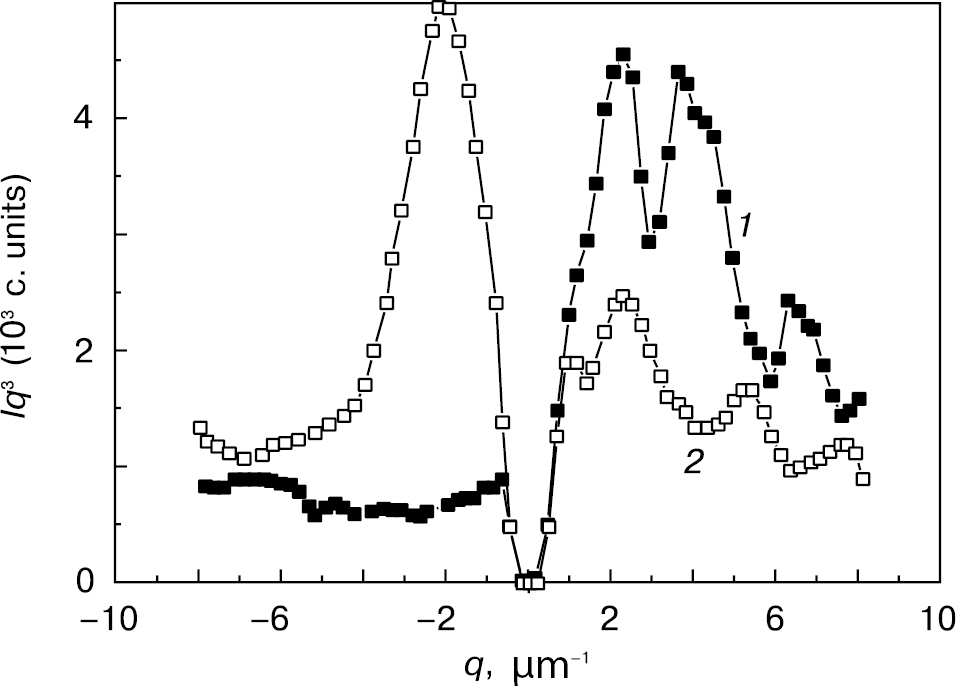
|
||
|
XRDS scattering intensity distribution along qz║[111] direction for two points of GaAs(Si) specimen section (n = 4.8·1018 cm–3) near the [[333]] site: (1) Region where dislocation loops were observed; (2) region where dislocation loops were not observed. |